
方案一体化提供商
01 HTRBHTRB(High Temperature Reverse Bias)主要用于验证长期稳定情况下芯片的漏电流,考验对象是边缘结构和钝化层的弱点或退化效应。HTRB是分立器件可靠性最重要的一个试验项目,其目的是暴露跟时间、应力相关的...
01 HTRB
HTRB(High Temperature Reverse Bias)主要用于验证长期稳定情况下芯片的漏电流,考验对象是边缘结构和钝化层的弱点或退化效应。
HTRB是分立器件可靠性最重要的一个试验项目,其目的是暴露跟时间、应力相关的缺陷,这些缺陷通常是钝化层的可移动离子或温度驱动的杂质。半导体器件对杂质高度敏感,杂质在强电场作用下会呈现加速移动或扩散现象,最终将扩散至半导体内部导致失效。同样的晶片表面钝化层损坏后,杂质可能迁移到晶片内部导致失效。HTRB试验可以使这些失效加速呈现,排查出异常器件。
以碳化硅MOSFET为例,测试原理图如下:
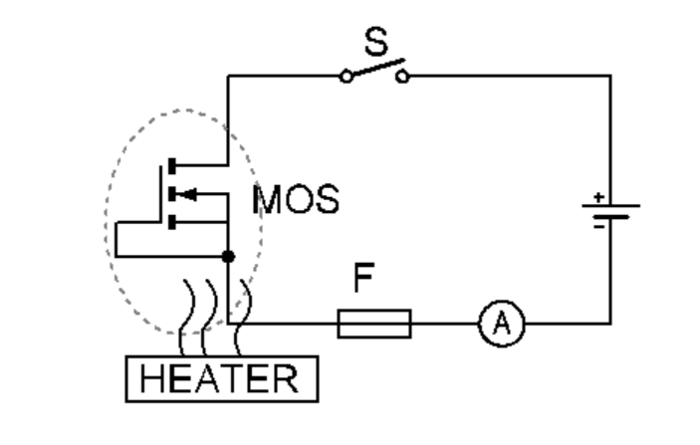
在测试中,需持续监测碳化硅MOSFET源极-漏极的漏电流。试验前后都要进行电应力测试,如器件静态参数测试结果超出规定范围,则判定为失效。
02 HTGB
HTGB(High Temperature Gate Bias)是针对碳化硅MOSFET进行的最重要的可靠性项目,主要用于验证栅极漏电流的稳定性,考验对象是碳化硅MOSFET栅极氧化层。在高温环境下对栅极长期施加电压会促使栅极的性能加速老化,且碳化硅MOSFET的栅极长期承受正电压,或者负电压,其栅极阈值电压VGSth会发生漂移。
测试原理图如下:
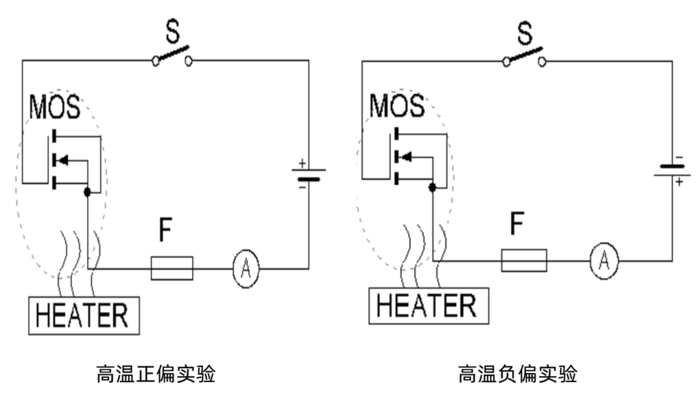
在测试中,需持续监测碳化硅MOSFET栅极-漏极的漏电流,如果漏电流超过电源设定上限,则可以判定为失效。试验前后都要进行电应力测试,如器件静态参数测试结果超出规定范围,则判定为失效。
03 HV-H3TRB
HV-H3TRB(High Voltage, High Humidity, High Temp. Reverse Bias)主要用于测试温湿度对功率器件长期特性的影响。高湿环境是对分立器件的封装树脂材料及晶片表面钝化层的极大考验,树脂材料是挡不住水汽的,只能靠钝化层,3种应力的施加使早期的缺陷更容易暴露出来。
AEC-Q101中只有H3TRB这个类别,其缺点是反压过低,只有100V。基本半导体将标准提高,把反偏电压设置80%~100%的BV,称为HVH3TRB。
以碳化硅MOSFET为例,测试原理图如下:
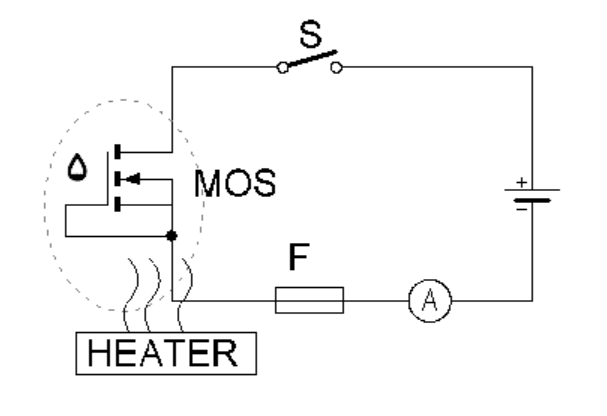
在测试中,需持续监测MOSFET源极-漏极的漏电流。试验前后都要电应力测试,如器件静态参数测试结果超出规定范围,则判定为失效。
04 TC
TC(Temperature Cycling)测试主要用于验证器件封装结构和材料的完整性。
绑定线、焊接材料及树脂材料受到热应力均存在老化和失效的风险。温度循环测试把被测对象放入温箱中,温度在-55℃到150℃之间循环(H等级),这个过程是对封装材料施加热应力,评估器件内部各种不同材质在热胀冷缩作用下的界面完整性;此项目标准对碳化硅功率模块而言很苛刻。
以碳化硅MOSFET为例,测试原理图如下:
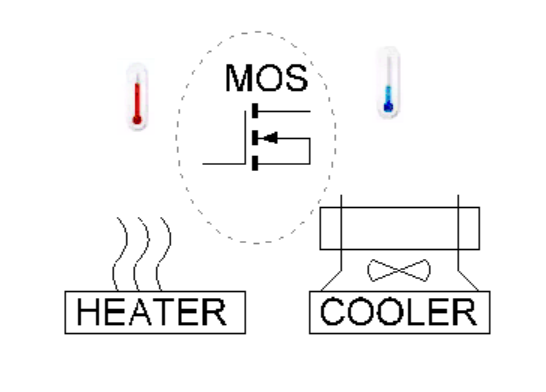
试验前后都要进行电应力测试,如器件静态参数测试结果超出规定范围,则判定为失效,并需检查封装外观是否发生异常。
05 AC
AC(Autoclave)测试主要用于验证器件封装结构密闭完整性。该测试是把被测对象放进高温高湿高气压的环境中,考验晶片钝化层的优良程度及树脂材料的性能。被测对象处于凝露高湿气氛中,且环境中气压较高,湿气能进入封装内部,可能出现分层、金属化腐蚀等缺陷。
以碳化硅MOSFET为例,测试原理图如下:

试验前后都要进行电应力测试,如器件静态参数测试结果超出规定范围,则判定为失效,并需检查封装外观是否发生异常。
06 IOL
IOL(Intermittent Operational Life)测试是一种功率循环测试,将被测对象置于常温环境TC=25℃,通入电流使其自身发热结温上升,且使∆TJ≧100℃,等其自然冷却至环境温度,再通入电流使其结温上升,不断循环反复。此测试可使被测对象不同物质结合面产生应力,可发现绑定线与铝层的焊接面断裂、芯片表面与树脂材料的界面分层、绑定线与树脂材料的界面分层等缺陷。
以碳化硅MOSFET为例,测试原理图如下:
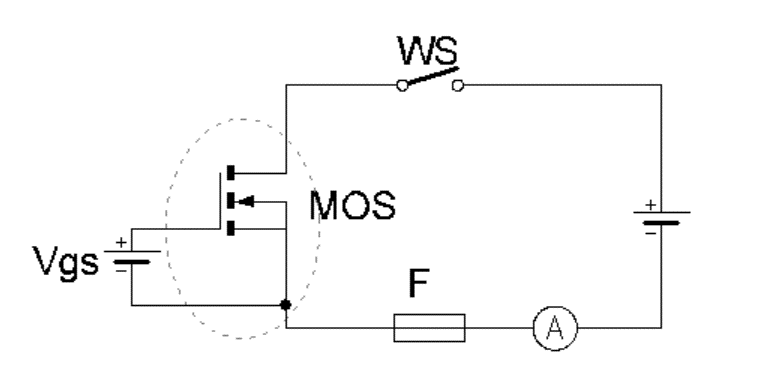
试验前后同样都要进行电应力测试,如器件静态参数测试结果超出规定范围,则判定为失效,并需检查封装外观是否发生异常。
金凯博碳化硅SiC车规级动态可靠性测试系统具有80个测试通道、每个通道独立控制;实时保存测试结果,生成测试报告;具有防烫、过流、过压保护;支持扩展外接标准仪表等众多优势性能。并具有高温高压高频高精度脉冲源:dv/dt>50v/ns、频率50KHz;高精度测试:电流分辨率10pA,电压分辨率100nV;多参数测量:Vsd电压、Vgsth电压、Rds电阻、lgss漏电流、ldss漏电流、温度,功能完备并有可扩展性。
参数测试:
1、Vgsth测试条件: G,D和S之间加管子规定电流,测试G和S之间的电压值;电压值就是阀值电压。
2、VSD测试条件: G和S之间加反向电压,D和S之间加反向管子规定电流,测试D和S之间的电压值;电压值就是反向二极管导通电压。
3、RDS测试条件: G和S之间加正向电压,D和S之间加正向管子规定电流,测试D和S之前的电压值;内阻 Rds(mΩ)=Vds / Ids (DS之间电压/DS流过的电流)。
4、Igss测试条件: G和S之间加管子规定电压,D和S接0V,测试出流过G极的电流就是Igss漏电流;
5、Idss测试条件: D和S之间加管子规定电压,G和S接0V,测试出流过D极的电流就是Idss漏电流;
2024-08-26
2024-06-28
2024-04-23
2024-04-12
2024-04-01
2024-03-28
2024-01-15
2022-12-17
2022-10-18
2022-08-11
2024-08-09
2024-08-09
2024-08-09
2024-08-08
2024-08-08
2024-08-08
2024-08-07
2024-08-07
2024-08-07
2024-08-06